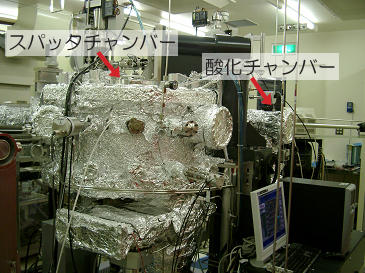 |
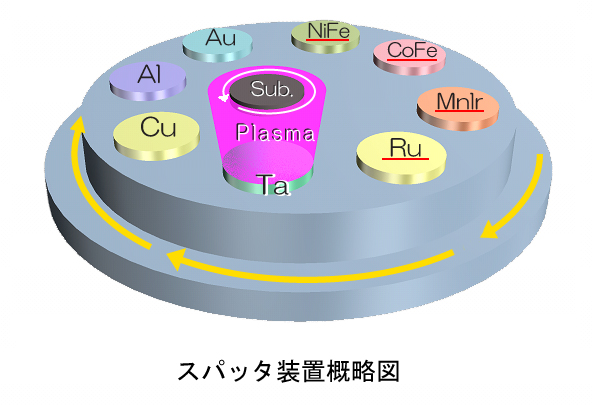 |
スパッタ装置
(Sputtering system)
| スパッタ法は,Arなどの不活性ガスイオンをターゲットに衝突させ,ターゲット表面から叩き出された原子や分子を基板上に堆積させ薄膜を形成する手法です. 本スパッタ装置は,チャンバー内に8つのターゲットが配置され,ターゲット構成元素である異種物質を原子サイズオーダー(10−10 Torr)で基板上に積層することができます.また,併設されている酸化チャンバー内へ大気暴露せずに真空中で基板搬送することで数nm厚の金属膜の自然酸化/ラジカル酸化が可能です.さらに,スパッタ/酸化チャンバー共に10−10 Torr程度の超高真空(UHV)となっており,残留大気などの不純物が抑制された清浄環境での薄膜形成プロセスを可能としています. 本装置を用いることで,磁性ランダムアクセスメモリー(Magnetic Random Access Memory: MRAM)の主要部分である巨大磁気抵抗(Giant Magnetoresistance: GMR)/トンネル磁気抵抗(Tunneling Magnetoresistance: TMR)膜の形成ができます. |
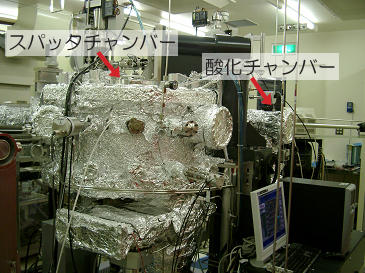 |
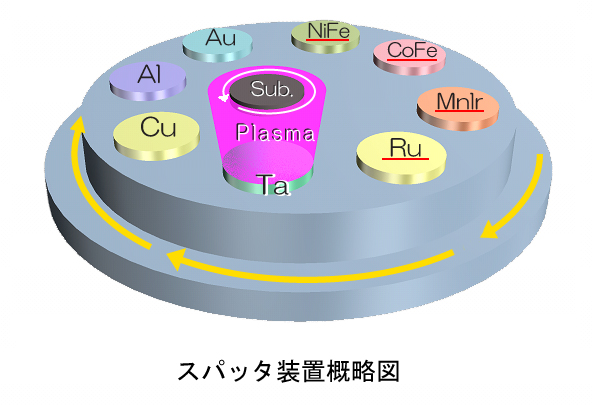 |